- 식각공정의 구분
식각공정인 Etching 공정은 어떠한 방식으로 식각이 진행되는지에 따라서 구분이 가능하다.
큰 틀에서 볼 때 식각방법/식각반응/식각형태 세가지 방식으로 구분하고 그 안에서 각 두가지로 나뉘어진다.
| 식각방법에 따른 구분 | 습식식각 Wet Etch |
| 건식식각 Dry Etch | |
| 식각반응에 따른 구분 | 화학적 식각 Chemical Etch |
| 물리적 식각 Physical Etch | |
| 식각형태에 따른 구분 | 등방성 식각 Isotropic Etch |
| 이방성 식각 Anisotropic Etch |

- 건식식각 Dry Etch
건식식각은 반응 방식에 따라서 크게 Chemical/Physical/Reactive Ion Etch(RIE) 의 3가지 종류로 분류할 수 있다.
1) Chemical Etch (High Pressure Plasma Etching)

Chemical Etch 기법은 High Pressure Plasma Etching이라고도 불리는데, 이 방식은 반응성이 좋은 활성종 (Radical)이 박막의 표면에 흡착하여 화학 반응을 통해 식각이 진행되는 방식이다.
즉, Etching 하고자 하는 Layer 원자와 플라즈마로 인해 생성된 Radical을 서로 반응시키는 것이다.
1. Plasma의 상태인 챔버 내에 Gas가 주입되면 Radical이 생성
2. Etch할 표면에 Radical이 퍼짐
3. Layer 표면에 Radical이 흡착됨
// (2~3)과정에서 Ion Bombardment 발생.
4. 반응성이 높은 Radical과 PR이 없어 보호받지 못하는 Layer 표면이 반응함
5. Radical과 Layer가 반응한 후 부산물 (byproducts)이 발생함. (이때 발생한 부산물은 volatile 휘발성을 띔)
6. 발생한 Volatile한 Byproduct이 주입되고 있는 Gas의 주입 방향대로 휘발되어 날아감. (Diffusion)
Chemical Etch의 장점 : 특정 Layer에 반응하는 Radical을 형성시켜 반응시키므로 높은 Selectivity를 가짐.
단점 : 화학반응 자체가 Isotropic(등방성) 반응이기 때문에 Undercut 현상이 발생.
*Undercut

2) Physical Etch - Sputtering Etch (Ion 식각)


다음은 물리적인 방식의 Etch이다. 고에너지를 갖는 Ion을 이용해 박막의 표면에 고속으로 충돌시켜 박막 표면의 물질을 물리적으로 제거하는 방식이다. 대부분 Ar가스를 이용한다.
1. Plasma 상태인 Chamber 안에 불활성 Ar가스를 주입한다.
2. Plasma에너지에 의해 Ar가스가 Ar+ 이온과 자유전자로 쪼개진다. (쪼개지지 않더라도 이후 이온발생에 도움을 줌)
3. 이후 Chamber 내부 전극에 +전압을 걸어주면 전자가 가속되고 Ar원자와 충돌시켜 Ar+이온의 발생을 증가시킨다.
4. 발생한 Ar+이온은 전자와의 물리적인 충돌로 가속되고 PR의 보호를 받지 못하는 Layer와 충돌하게 된다.
5. Ar+와 충돌한 Layer 표면은 이온 하나당 원자 하나의 꼴로 Etching 된다.
장점 : Anisotropic한 비등방성 반응의 장점을 갖는다.
단점 : 물리적으로 충돌시키는 방식이라 특정 Layer만의 반응을 유도하기 어렵다. (Low Selectivity & Low Throughput)
*이온이 Ar와 충돌하는 각도의 영향.



* Sputtering Etch는 휘발성이 아닌 생성물도 제거할 수 있다. 하지만 그 부산물이 다시 증착되는 Redeposition을 막기 위해 낮은 압력에서 Mean free path를 키운 상황에서 공정이 진행되어야 한다.
3) Reactive Ion Etching (RIE)
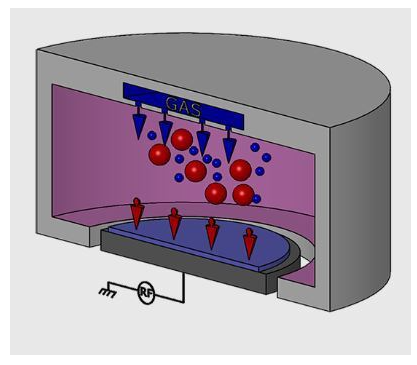
Chemical 방식과 Physical 방식의 단점들을 모아보면 Isotropic, Low selectivitiy, Low Throughput 이다.
이러한 단점들을 보안하기 위해 탄생한 기법이 바로 RIE 방식이다.
RIE는 Chemical&Physical 장점을 적절히 섞은 Hybrid 방식이라고 생각하면 된다.
Chamber 내부 Cathode 전극에 13.56MHz의 RF 전압을 걸어주고. Anode 전극에는 Ground 시켜 Plasma를 발생시킨다.
여기서 플라즈마 내에 있는 이온들이 RF 전압이 물려있는 Substrate 쪽으로 움직이면서 Layer과 부딪히고 떨어지고를 반복한다. 이 과정에서 Layer가 Etching된다.
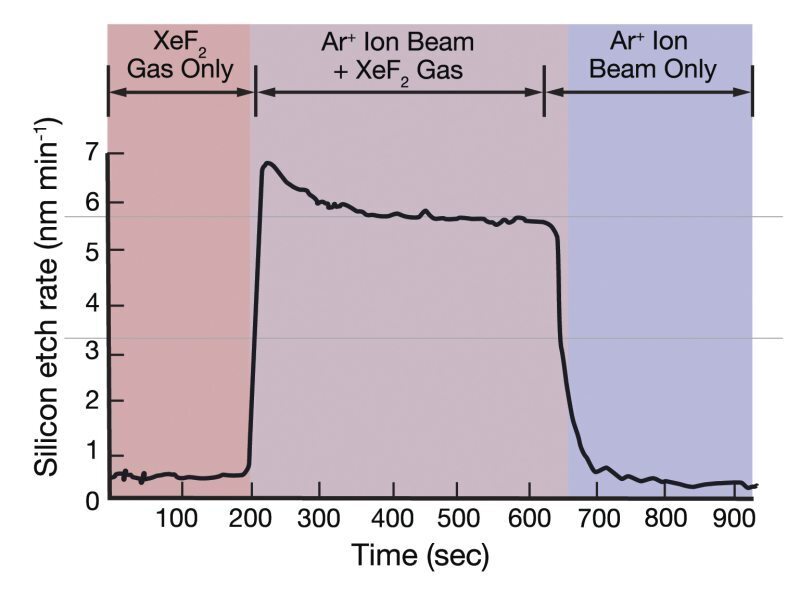
1. Plasma Chamber 내에 양이온 가스(Ar+)를 주입한다.
2. 주입된 양이온 입자들이 식각하고자 하는 Layer에 이끌려 표면에 충격을 준다. (결합을 약하게 만듦)
3. 결합이 약해진 Layer 표면에 Plasma 내의 XeF2 가스의 Radical과 반응한다.
4. 반응하고 남은 Volatile Byproducts를 배출한다.
5. Chemical&Physical 방식으로 Etching을 진행시킨다.
RIE 방식은 순수 Chemical 방식이나 Physical 방식의 모든 장점을 가지면서 기존 식각률보다 월등히 높고, Isotropic 특징과 High Selectivity & Thoroughput 특성을 모두 가지게 된다.
'반도체 공정 > Etching (식각)' 카테고리의 다른 글
| 습식식각 - Si / 산화막 / Si3N4 / Al / GaAs (0) | 2022.03.08 |
|---|---|
| 식각 - Etching (0) | 2022.03.02 |